2.7. Полупроводниковые источники излучения
Светодиоды. Если при поглощении света в полупроводнике происходит генерация неравновесных электронно-дырочных пар, то при выключении света неравновесные электроны и дырки рекомбинируют друг с другом. при этом, будет ли рекомбинация происходить с излучением квантов света или нет, зависит от структуры энергетических зон используемого полупроводника.
В некоторых широкозонных полупроводниках (GaAs, GaP, SiC) минимум зоны проводимости расположен над максимумом валентной зоны. Переходы электронов из зоны в зону в таких полупроводниках могут быть прямыми, т. е. происходят без изменения квазиимпульса. Поэтому межзонные переходы могут осуществляться без участия фононов, вследствие чего вероятность прямых переходов велика. отсюда следует и большая вероятность излучательной рекомбинации носителей тока.
Неравновесные носителив полупроводнике проще всего создавать инжекцией их через p-n-переход. При включении p-n-перехода в прямом смещении происходит инжекция электронов в р-область, дырок в n-область и их последующая рекомбинация с основными носителями. При этом могут реализовываться как оптические переходы из зоны в зону, так и переходы на примесные уровни. например, в диодах из арсенида галлия излучательная рекомбинация происходит в р- области при переходах инжектированных электронов из зоны проводимости на примесные акцепторные уровни вблизи валентной зоны. Частота излучения определяется разностью энергий между уровнями, где находились электрон и дырка до рекомбинации. изменять частоту излучения можно введением примесей, создающих акцепторные уровни на другом расстоянии от валентной зоны.
В реальных полупроводниках рекомбинация происходит не между электронами и дырками на двух уровнях, а между электронами, находящимися на одной группе уровней, и дырками на другой, вследствие чего спектр излучения оказывается размытым.
Энергетической характеристикой излучающих диодов (светодиодов) является квантовая эффективность, которая определяется как отношение числа излучаемых во вне фотонов к числу электронов, проходящих через p-n - переход. Хотя эта величина теоретически может достигать 100%, практически она порядка 0,1... 1%. Это объясняется большой долей безызлучательных переходов в общем рекомбинационном процессе и малостью доли фотонов, выходящих из светодиода. С понижением температуры вероятность излучательной рекомбинации растет и квантовая эффективность увеличивается.
Отличительными особенностями светодиодов по сравнению с обычными источниками света являются малые размеры, малые рабочие напряжения, высокое быстродействие (~10-9 с) и большой срок службы. Светодиоды находят широкое применение для схем автоматики, световых табло, оптронов и др.
Лазер на p-n-переходе. В собственном полупроводнике в зоне проводимости всегда имеются свободные электроны и дырки в валентной зоне, образованные в результате термогенерации (равновесные носители). при прохождении света через полупроводник электроны из валентной зоны поглощают кванты света и переходят в зону проводимости, если частота падающего света n>Eg/h. Следовательно, интенсивность света уменьшится при прохождении через полупроводник. одновременно падающее на полупроводник излучение стимулирует переходы возбужденных электронов из зоны проводимости в валентную зону. при этом излучаются кванты света (рис.2.14). эти кванты добавятся к внешнему излучению при прохождении его через полупроводник, т. е. произойдет усиление света.
Рис. 2.14. Межзонные переходы при действии излучения на полупроводник
Переходы, происходящие под воздействием внешнего излучения, называют индуцированными в отличие от спонтанных переходов, происходящих независимо от внешнего излучения. В состоянии термодинамического равновесия число электронов в валентной зоне во много раз больше, чем в зоне проводимости. Следовательно, поглощение света преобладает над усилением. Для усиления света надо создать такие условия, когда концентрация электронов около дна зоны проводимости будет больше концентрации их вблизи потолка валентной зоны (n2> n1). такое состояние полупроводника называется состоянием с инверсией населенностей уровней. Коэффициент усиления света а при прохождении его через полупроводник зависит соответственно от разности населенностей верхних и нижних уровней. Поскольку вероятности переходов электронов г вверх и вниз равны, то можно записать а~hnг?n, где ?n=n2-n1 — разность населенностей верхних (дно зоны проводимости) и нижних (потолок валентной зоны) уровней. очевидно, усиление будет, когда ?n>0.
К ослаблению света, проходящего через полупроводник, приводят не только переходы электронов из валентной зоны в зону проводимости, но и рассеяние света на различных неоднородностях кристалла и т. д. В результате интенсивность света изменяется с расстоянием х внутрь полупроводника по закону ф=ф0ехр(а- cп)х, где коэффициент cп характеризует потери.
Таким образом, полупроводниковый кристалл усиливает внешнее излучение, если в нем существует инверсия населенностей уровней и коэффициент усиления превосходит коэффициент потерь (а>cп).
Для того чтобы превратить усилитель в генератор излучения, необходимо ввести обратную положительную связь, т. е. часть излучения с выхода подать на вход. В квантовых генераторах света (лазерах) для создания обратной связи рабочий кристалл помещают между двумя параллельными зеркалами (1 и 2 на рис.2.15). свет, пройдя через кристалл, усилится в ехр(а - cп)l раз, затем отразится от зеркала, пройдет еще раз через кристалл и усилится снова во столько же раз и т. д. Первичные кванты света возникают за счет спонтанных переходов, а затем происходит усиление света при распространении его в кристалле за счет индуцированных переходов.
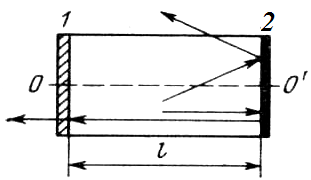
рис. 2.15.схема лазера
Следует отметить, что усилитель с положительной обратной связью может стать генератором только тогда, когда усиление превосходит все потери излучения в устройстве. Поэтому необходимо учесть потери, вносимые устройством обратной связи, т. е. зеркалами. При отражении от зеркала интенсивность света уменьшается в r раз, где r — коэффициент отражения. для простоты будем считать, что это уменьшение происходит не скачком (при отражении), а непрерывно в пространстве между зеркалами, и введем эквивалентный коэффициент поглощения на единицу длины cз =1-r/1. Кроме этого, для вывода излучения из кристалла необходимо одно из зеркал сделать полупрозрачным (например, 1 на рис. 2.15), что приводит к дополнительным потерям на вывод излучения Cи.
в результате условие возникновения генерации примет вид
а>CП +Cз +CП
Очевидно, что чем больше потерь излучения в лазере, тем больше должно быть а, т. е. тем больше должна быть инверсия населенностей уровней (n2>n1). Инверсию населенностей уровней
полупроводника можно создать многими способами. Один из них заключается в облучении собственного полупроводника интенсивным светом (оптическая накачка). частота света должна быть такой, чтобы hvн>Eg. при этом электроны из валентной зоны переходят в зону проводимости и скапливаются там. При достаточно большой интенсивности накачки может наступить инверсия населенностей уровней. Другим методом является перевод электронов из валентной зоны в зону проводимости бомбардировкой полупроводника быстрыми электронами. С помощью обоих методов можно получать большие мощности излучения, однако в целом к. п. д. устройств невелик.
Наибольшим к. п. д. и простотой конструкции обладает лазер на р-n-переходе. Рассмотрим, например, наиболее широко распространенную конструкцию лазера на p-n-переходе из арсенида галлия. Действие лазера основано на том, что при прямом смещении электроны инжектируются в р- область, где происходит их излучательная рекомбинация с имеющимися там дырками. Для создания состояния с инверсией населенностей необходима большая концентрация дырок в валентной зоне, что достигается увеличением концентрации легирующей акцепторной примеси. Для того, чтобы инжекция электронов в р- область превышала инжекцию дырок в n- область (где рекомбинация безызлучательная, а следовательно, ток дырок в n-область целиком относится к потерям), необходимо, чтобы концентрация донорной примеси в n-области была выше концентрации акцепторной примеси в p - области, т. е. nn>pp.
Таким образом, для получения состояния с инверсией населенностей в p- области необходима высокая степень легирования примесями обеих областей p-n-перехода.
По мере увеличения концентрации примесей в полупроводнике происходят следующие изменения в энергетической диаграмме. При увеличении концентрации донорной примеси уровень ферми приближается к дну зоны проводимости. Из-за взаимодействия примесных атомов, при достаточно большой их концентрации, локальные уровни атомов примеси расщепляются и образуют примесную зону, которая при достаточной ее ширине может перекрываться с зоной проводимости. Если при этом уровень Ферми был выше нижних донорных уровней примеси, то он окажется внутри разрешенной зоны. Вследствие этого энергетическая диаграмма полупроводника изменится. Во-первых, уменьшится Eg и во-вторых, уровень Ферми будет расположен в разрешённой зоне. Аналогичные изменения произойдут и при увеличении концентрации акцепторной примеси в полупроводнике p-типа, но уровень Ферми будет расположен в валентной зоне. Такие полупроводники называются вырожденными вследствие того, что электроны ведут себя подобно вырожденному электронному газу. Вырожденные полупроводники и используются при создании лазеров на p-n- переходе, поскольку в полупроводнике с высокой концентрацией легче создать состояние с инверсией населённостей.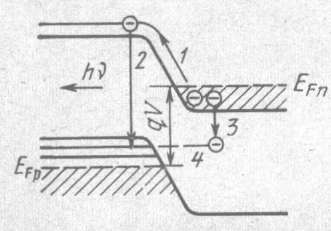
Рис.2.16. Межзонные переходы в p-n-переходе из вырожденных полупроводников при прямом смещении
Энергетическая диаграмма p-n- перехода между вырожденными полупроводниками при прямом смещении показана на рис. 2.16.
При подаче прямого смещения электроны из n - области инжектируются в р - область, где и происходит их рекомбинация с дырками (переход 1—2). При малых токах через p-n -переход уровень инжекции невелик, инверсии населенностей не будет и индуцированное излучение не возникает. С ростом тока а увеличивается и при некотором пороговом токе iпор выполнится условие генерация и диод начнет излучать свет. излучателем является узкая часть р- области, прилегающая к p-n -переходу. Конструкция лазерного диода показана на рис. 24. Зеркалами являются гладкие грани самого полупроводникового кристалла, получаемые обычно скалыванием его краев.
Рассмотрим отличия излучения светодиода от лазерного диода. В светодиоде излучение является спонтанным, т. е. разные части излучающей области излучают независимо друг от друга. В результате источник излучает совокупность световых волн, распространяющихся во всех направлениях, а интенсивность света убывает обратно пропорционально квадрату расстояния от источника.
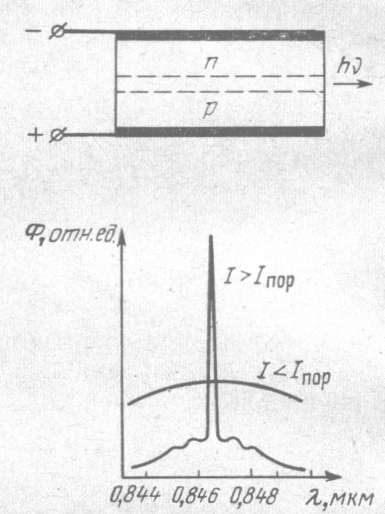
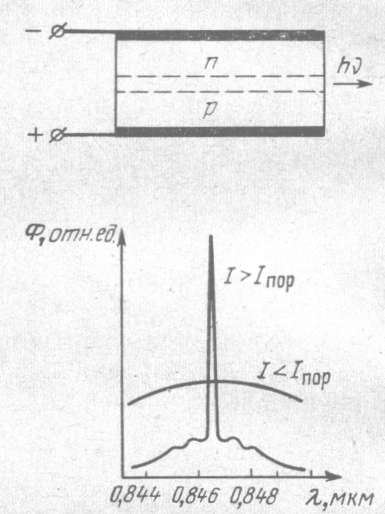
Рис.2.17. конструкция лазера на p-n-переходе и спектр его излучения
В лазере, благодаря использованию оптического резонатора, все световые волны, направленные под углом к оси активной области (00' на рис. 2.15), сразу или после нескольких отражений выходят в сторону и не усиливаются. кроме того, лазерное излучение образуется в результате согласованного, индуцированного перехода электронов из зоны проводимости в валентную зону во всей излучающей части p-области. Поэтому пространственная когерентность сохраняется во всем поперечном сечении выходящего луча света.
На основе всего изложенного теперь можно объяснить изменения в спектре излучения лазерного диода при переходе от работы в спонтанном режиме излучения (I<IПор) к индуцированному (I>IПор, рис.2.17). При малых токах излучение является спонтанным, т. е. происходит на большом спектре волн. С ростом тока, как только I>IПор. излучение станет индуцированным, а, следовательно, более монохроматическим.
Лучшим материалом для лазерных диодов в настоящее время является арсенид галлия. толщина излучающей части р- области порядка 2 мкм. Лазерный диод является первым лазером, в котором удалось осуществить прямое преобразование электрической энергии в энергию когерентного светового излучения. Он также имеет наибольший к. п. д. и высокое быстродействие. Лазерные диоды могут применяться в световых локаторах для наблюдения и фотографирования в темноте, в дальномерах, а также для связи, так как в них чрезвычайно просто осуществлять модуляцию светового излучения путем изменения амплитуды или частоты питающего напряжения. Хотя теоретически к. п. д. лазерных диодов может приближаться к 100%, практически он намного меньше. Главная причина этого — необходимость в сильном легировании p- и n - областей p-n -перехода. Одновременно с введением примесей в полупроводнике образуется большое количество дефектов в активной области, что ведет к значительным потерям излучения. Кроме того, дефекты могут образовывать энергетические уровни в запрещенной зоне полупроводника. поскольку концентрация примесей в обеих частях p-n-перехода велика, то ширина p-n-перехода мала, а следовательно, носители тока могут из зоны проводимости переходить на эти уровни, а затем туннелировать в валентную зону р- области (рис.2.16, переход 3 – 4).Туннельный ток не связан с излучением и это также ухудшает к.п.д.
Вследствие этих причин для возникновения индуцированного излучения требуется большая величина пороговой плотности тока. Большая плотность тока через p-n-переход приводит к деградации параметров лазерных диодов, а также к необходимости создания громоздких систем охлаждения. поэтому суммарный квантовый выход составляет величину не больше 2 ... 3% при комнатной температуре. Пороговые плотности токов порядка 104 А/см2.
Инжекционные гетеролазеры. Указанные недостатки могут быть устранены в p-i-n (а также p-n-n+ или n-р-р+)-диоде с гетеропереходами. В таком лазере средним активным слоем служит материал с меньшей шириной запрещенной зоны, а эмиттерами — материалы с большей шириной запрещенной зоны. Как отмечалось ранее, гетеропереходы отличаются высоким отношением инжекционного тока, из широкозонного полупроводника в узкозонный к обратному. При включении диода в прямом направлении происходит инжекция электронов и дырок в среднюю область, где они и рекомбинируют с излучением света. На рис.2.18 приведена энергетическая диаграмма структуры, где материалами областей являются тройные соединения: n-Alx1Ga1-x1As, p-Alx2Ga1-x2As, р+-А1xзGa1-x3As. Различная ширина запрещенной зоны получается за счет изменения соотношения компонентов (значения х).
Рис. 2.18. энергетическая диаграмма n—р— р+- гетероперехода при прямом смещении
Инверсия населенностей в таком лазере достигается высоким уровнем инжекции электронов и дырок в узкозонную часть. Поэтому нет необходимости в высоком уровне легирования активной области. В результате этого резко снижаются потери излучения в активной области, а следовательно, и величина пороговой плотности тока, которая в настоящее время для гетеролазера, работающего при комнатной температуре, порядка 900 А/см2. Квантовая эффективность у лучших образцов достигает 70%. Ширина активной области в гетеролазере может быть много больше ширины активной области лазера на гомо- p-n-переходе, поэтому в гетеролазере могут быть получены, гораздо большие интенсивности излучения.
Несмотря на трудности, связанные с технологией производства гетеропереходов, можно надеяться, что в ближайшее время гетеролазеры прочно займут свое место в оптоэлектронике.